728x90
반응형
HBM은 1세대(HBM)-2세대(HBM2)-3세대(HBM2E)-4세대(HBM3) 순으로 개발돼 왔으며 2024년 5세대(HBM3E)에 이어 이르면 2025년에는 6세대 HBM4가 출시될 것으로 예상된다.
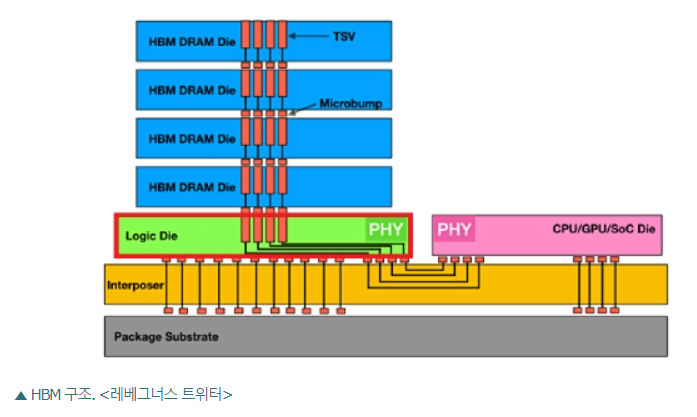
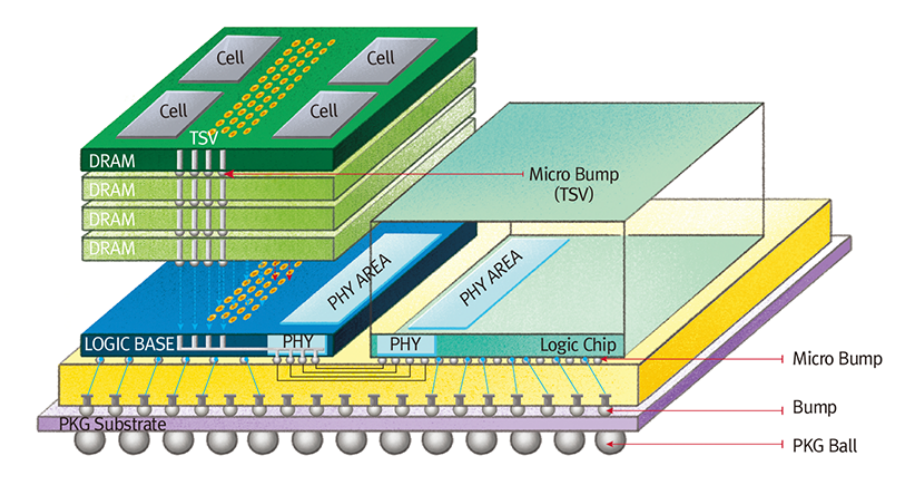
HBM은 여러 개의 D램이 로직(시스템)다이 위에 수직으로 연결되는 구조인데 HBM4에는 로직다이 제조에 핀펫 공정이 처음으로 도입될 것으로 보인다.

SiP와 SoC의 성능을 비교할 때 예전에는 하나의 칩으로 구현된 SoC의 전기적 특성이 무조건 더 좋다고 생각되어 왔다. 그런데 칩 적층 기술, 특히 TSV를 이용한 칩 적층 기술이 나오면서 SiP도 SoC 못지않은 전기적 특성을 가지게 되었다
TSV
기존 와이어를 이용해 칩을 연결하는 대신 칩에 미세한 구멍을 뚫어 상단 칩과 하단 칩을 전극으로 연결하는 D램 칩을 일반 종이 두께의 절반보다도 얇게 깎은 후, 미세한 구멍을 뚫어 칩 상하단의 구멍을 전극으로 연결하는 패키징 기술이다. TSV는 메모리 칩을 적층해 대용량을 구현하는 기술로, 기존 금선(와이어)을 이용해 칩을 연결하는 와이어 본딩(Wire Bonding) 기술보다 속도와 소비전력을 크게 개선할 수 있는 것이 특징이다.

반도체 패키지 공정 중 웨이퍼간 또는 칩간 연결 방식은 크게 3가지 나눈다.
1. 와이어 본딩 : Chip + 기판을 금속 배선으로 연결
-상대적으로 속도가 느림,
- chip을 기판에 와이어로 하나하나 연결함
2. 플립칩 본딩 : chip 바닥에 연결용 범프를 부착 후 바닥을 아래로 향하도록 다시 뒤집어서 기판에 부착
-chip 이 기판에 직접 맞닿아 이동 경로가 단축되어 빠른 속도 구현이 가능함.
-기판과 맞닿는 부위만 연결이 되므로, 단일 chip이나 수평으로 이어붙인 구조에서만 적용 가능함.
3, TSV(Through silicon via): 여러겹 쌓인 chip 에 구멍을 뚤어 전류를 흐르게 함(수직 관통 전극)
-수직으로 빠르게 데이터 이동 가능
-전력 소모 감소(성능향상)
-패키지 사이즈를 감소(특히 두께)
HBM은 TSV 공정을 이용해 메모리 칩을 적증학여 데이터 처리 속도를 극대화한 고대역폭 메모리
-대용량 데이터 처리에 특화된 메모리(주로 gpu와 같은 고성능 분야에 활용 됨.
-초고온, 초절전, 초고속에 특화되어 있음(자율주행, 머신러닝, 등 향후 4차산업에 많은 데이터 처리가 필수인 만큼 적용 분약가 많아질 것으로 예상 됨
sip(system in package)
Package 안에 여러 개의 ic와 passive component 가 실장되어 복합적인 기능을 하나의 system으로 구현하는 제품이다.

728x90
반응형
'트랜드 키워드' 카테고리의 다른 글
| 반도체 CXL과 HBM 차이점 (0) | 2023.12.19 |
|---|---|
| 반도체 공정 그리고 HBM (0) | 2023.12.19 |
| 프롬프트 엔지니어링 (1) | 2023.12.19 |
댓글